光电共封装器件(CPO) 光子与电子集成电路的融合创新
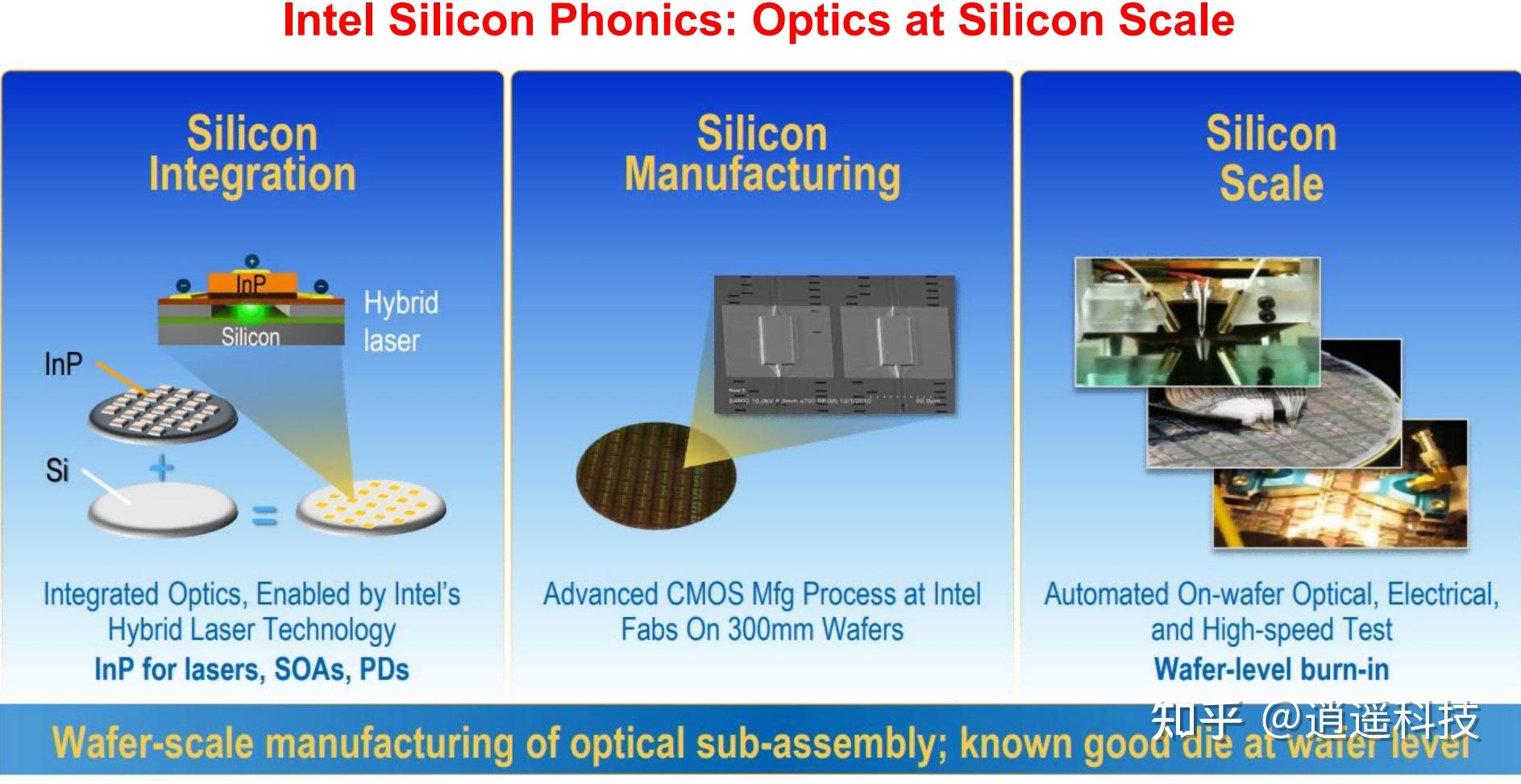
随着数据通信速率迈向800G甚至1.6T时代,传统可插拔光模块在功耗、密度和成本上面临严峻挑战。在此背景下,光电共封装器件(CPO, Co-Packaged Optics)作为一种前沿的集成技术方案应运而生,它通过将光子集成电路(PIC)与电子集成电路(EIC)在同一个封装基板或中介层上紧密集成,旨在突破“带宽墙”与“功耗墙”,为下一代高性能计算与数据中心互连提供核心支撑。
光电共封装器件的核心在于“共封装”与“异构集成”。它并非简单地将分立的光模块与交换芯片放在一起,而是通过先进的封装技术,将处理高速电信号的电子芯片(如交换机ASIC、CPU/GPU的I/O单元)与进行光电/电光转换的光子芯片(如激光器、调制器、探测器等构成的PIC)高密度地集成在同一个封装体内。这种集成通常利用硅中介层、硅光技术或2.5D/3D封装技术实现,使得电互连距离从厘米级大幅缩短至毫米甚至亚毫米级。
其技术优势显著:
- 大幅降低功耗:缩短了高速电信号在PCB板上的传输距离,显著减少了由通道损耗和阻抗不匹配带来的功耗,系统整体功耗预计可比可插拔方案降低30%-50%。
- 提升带宽密度:更紧密的集成释放了面板空间,允许在单位面积上部署更多光互连通道,轻松支持超高带宽需求。
- 改善信号完整性:超短距电互连有效降低了信号衰减、串扰和抖动,提高了传输质量,为更高速率(如224Gbps/通道及以上)奠定了基础。
- 优化系统成本:通过集成简化了系统设计,减少了材料(如DSP、TIA等)使用,长期看有助于降低单比特传输成本。
从系统架构看,CPO的实现路径多样。一种是“近封装光学”(NPO),将光引擎置于交换芯片封装基板附近,作为过渡方案。更激进的方案则是将硅光芯片与电子芯片通过微凸块等直接进行3D堆叠或并排集成,实现真正的片上光互连。目前,业界正围绕共同的外形尺寸、接口标准(如OIF的CPO框架协议)、散热管理以及高良率、低成本的大规模制造工艺进行攻关。
尽管前景广阔,CPO的全面商用仍面临挑战。技术层面,高功率激光光源的集成与高效散热、硅光工艺与先进封装工艺的协同、高精度耦合对准以及长期可靠性都是关键难题。产业生态上,它颠覆了传统光模块的供应链和价值链,需要芯片设计商、半导体代工厂、封装测试厂与光器件供应商进行前所未有的深度协同,重构产业分工。
光电共封装器件不仅是解决特定场景功耗和带宽问题的技术选项,更是通向“光计算”和更广泛光电融合系统的必经之路。随着人工智能、机器学习对算力需求的爆炸式增长,CPO有望率先在超大规模数据中心、高性能计算集群以及人工智能加速设备中得到应用,最终推动信息处理架构从“电为主”向“光电协同”的深刻变革。
如若转载,请注明出处:http://www.lm110.com/product/31.html
更新时间:2026-04-15 00:00:08








